-
Name
COF Flip Chip Eutectic Bonder
-
Chip Size
W: 1.5-5mm, L: 15-25mm, T: 0.2-1mm
-
TT
1.5sec(UPH: ~2K)
-
Accuracy
±1.5μm
-
Die Bonding Capacity
10-350N
-
Temperature
Chip side: 200-450℃
Substrate: 100-150℃
-
Wafer Size
8 inch and 12 inch
-
Substrate Size
35/48/70mm;25-112μm in thickness
-
Die Bonding Process
Flip chip & Eutectic bonding
-
COF Technology & Applications
COF (Chip on Film) is an IC packaging technology that bonds the Gold Bump on chips to the Inner Lead on flexible circuits via thermal compression.
COF is one of core components for LCD/OLED displays, COF Bonding adopts flip chip eutectic method.
COF Flip Chip Eutectic Bonder
The high-precision flip-chip eutectic bonding process interconnects display driver chip bumps with substrate leads to enhance packaging density and performance. This critical packaging equipment is widely applied in LCD/OLED display driver applications.
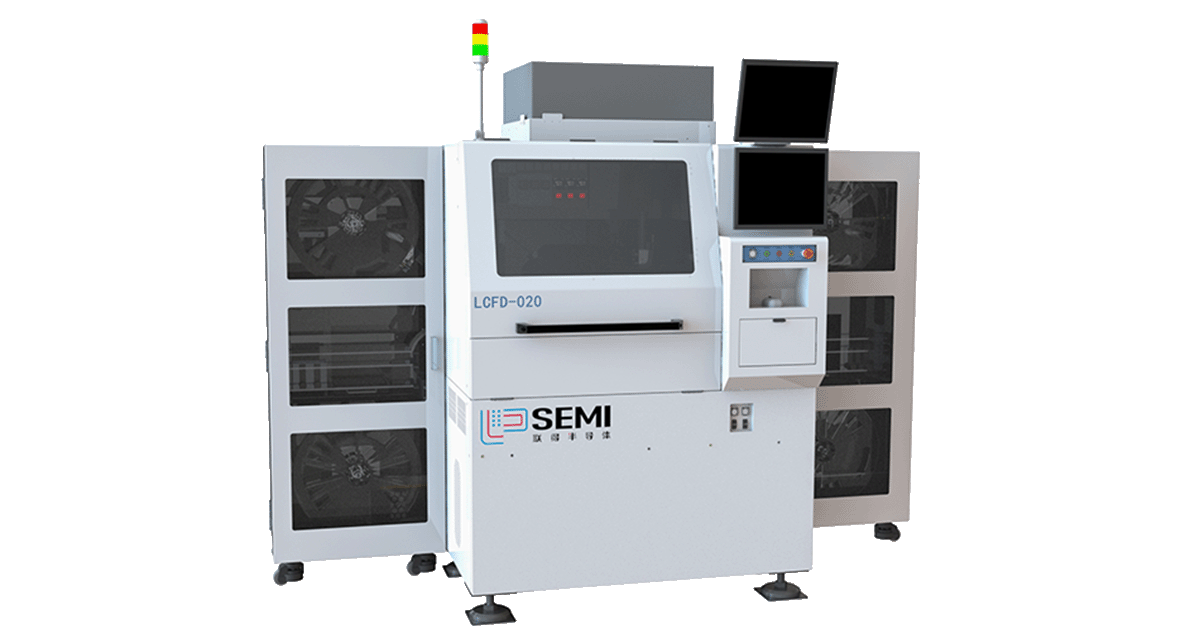
Details
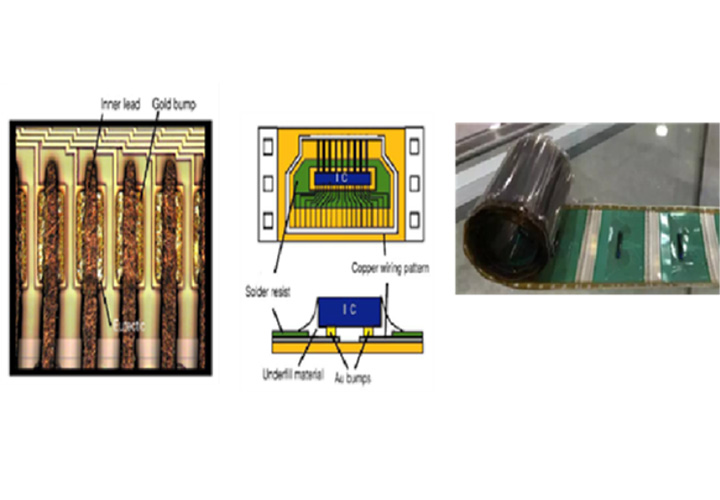
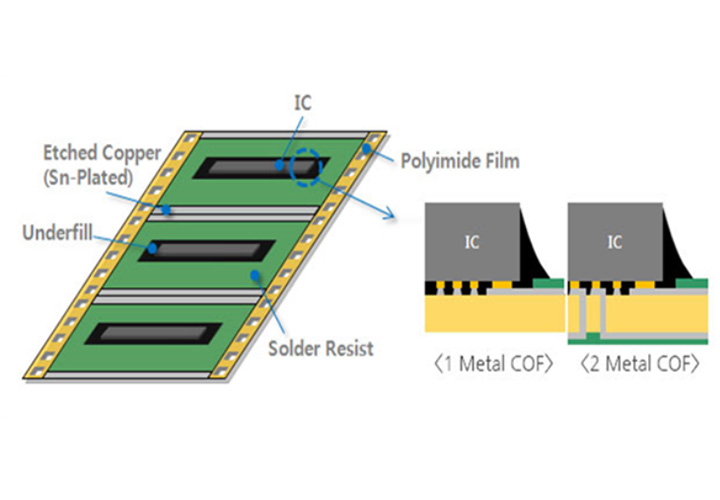

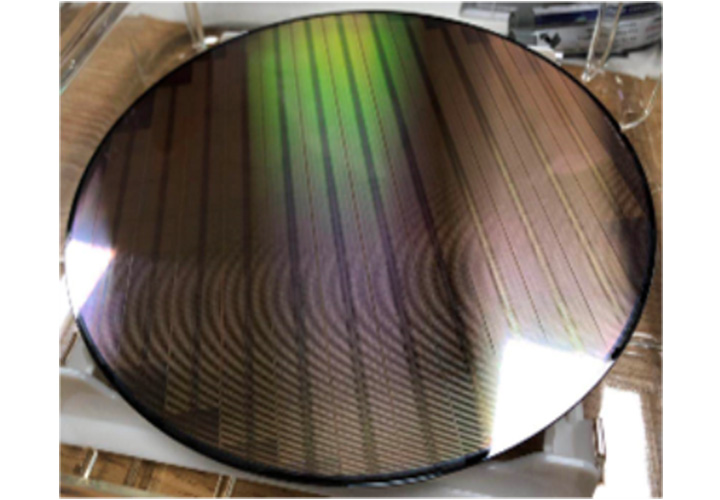
Technical Specification
Related Products

Are you looking for the right solution for your industry?
If you are looking for best solution to improve your productivity, please contact us, and we will be happy to assist you



