On August 6th, the "high-precision driver chip bonding equipment" independently developed by LianDe Semiconductor successfully rolled off the production line and was loaded for shipment.


The high-precision driver chip bonding equipment is a critical device in the field of semiconductor packaging, primarily used to achieve precise electrical and mechanical connections between flip chips and substrates (or other carriers).
Its core features and functions include:
High-Precision Positioning: It can achieve alignment accuracy at the micron or even nanometer level, ensuring that the solder balls or bumps on the chip are precisely aligned with the pads on the substrate. This precision is key to guaranteeing connection reliability and electrical performance.
Bonding Process Implementation: By applying specific temperature, pressure, and time parameters, it enables the formation of robust mechanical and electrical connections at the contact points between the chip and the substrate (such as solder bumps, copper pillars, etc.), completing the core process of flip-chip packaging.
Adaptation to Miniaturization Needs: As chip integration increases, chip sizes decrease, pin counts increase, and spacing between pins decreases (e.g., micro-bump technology). This equipment meets the demands for high-density, fine-pitch bonding required by these advancements.

- COF Wafer / PI Film / COF Finished Product
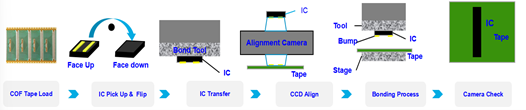
Process Flow of Flip-Chip Bonding Equipment for Display Driver Chips

Introduction to Inner Lead Bonding Technology Principle and COF Product
"High-precision Driver Chip Bonding Equipment" is widely used in advanced chip packaging, playing an irreplaceable and crucial role in enhancing the performance of semiconductor devices, reducing their size, and improving reliability.
The successful shipment of "high-precision driver chip bonding equipment" by Liande marks a significant leap and breakthrough in achieving full-chain technology localization in the field of display driver chip packaging. It fills the gap in domestically produced flip-chip equipment in this area, effectively breaking through the technological barriers imposed by Europe, America, Japan, and South Korea. This achievement highlights Liande Semiconductor's exploration and innovation capabilities in high-precision driver chip bonding equipment technology, strengthens Liande’s technical R&D reserves and engineering capabilities in advanced thermocompression bonding processes, hybrid bonding processes, and related equipment. It also represents an important milestone for Liande in the future continuous R&D and industrial development of semiconductor 2.5D/3D packaging, wafer-level packaging, panel-level packaging, system-in-package, and other chip bonding processes and equipment.
In the semiconductor industry, the primary indicator for measuring a company's strength and core technological competitiveness is its R&D capability. As a rising star in the industry, Liande Semiconductor has always been down-to-earth, prioritizing R&D and continuously exploring innovations over the years.

To ensure that the equipment quality reaches international top standards, improve bonding precision, and optimize equipment stability, ensuring that every piece of equipment delivered to customers performs at its best, the project technical team worked day and night. After countless trials and improvements, they meticulously managed every step from raw material procurement, component processing, to equipment assembly and debugging. The production process strictly followed standard operating procedures, with real-time monitoring and testing of each production stage. It is through this relentless pursuit of quality that the equipment successfully passed the rigorous performance tests conducted by customers, earning their favor and recognition.

On the day of shipment, it was raining heavily, and the continuous rainy weather had brought significant inconvenience to the delivery process. The equipment loading also faced risks of moisture and collision. The project research, development, and manufacturing team quickly formulated an emergency response plan and implemented a series of effective protective measures. To prevent the equipment from getting damp, they wrapped the equipment in thick waterproof covers and placed desiccants inside the vehicle. To avoid collisions during transportation, they carefully secured and protected the equipment, ensuring that every packing step was accurate and flawless. This demonstrates Liande's commitment to honoring their promises to customers and their strong execution capabilities.












